ГЛАВА 4. Процессы плазменной обработки неорганических материалов
6. Ионно-плазменное травление (ИПТ)
При ионно-плазменном травлении удаление поверхностных слоев материалов осуществляется за счет физического распыления ионами инертных газов или других ионов, химически не реагирующих с обрабатываемым материалом. При этом он находится в контакте с зоной плазмы, а необходимая энергия ионов обеспечивается подачей на материал отрицательного смещения. Для ионной очистки поверхности материалов (удаления адсорбированных частиц) обычно используют ионы с энергией в диапазоне от 20 до 100 эВ, а для ионного травления (удаления слоев основного материала) - от 100 до 1000 эВ. В первом диапазоне распыление осуществляется в режиме первичного прямого выбивания, а во втором - как в режиме первичного выбивания, так и в режиме линейных каскадов.
По способу возбуждения и поддержания электрического разряда системы ИПТ подразделяются на системы с разрядами постоянного тока (ПТ), системы с самостоятельными ВЧ разрядами, а также системы на постоянном токе и высокой частоте с искусственным поддержанием разряда, где разряд поддерживается с помощью вспомогательных средств: термоэлектронной эмиссии, ВЧ и магнитных полей. Системы ИПТ можно классифицировать по числу электродов на двухэлектродные (диодные), трехэлектродные (триодные) и многоэлектродные (четыре и более электродов). Кроме того, по форме и расположению электродов системы ИПТ могут быть горизонтальными с плоскими электродами (планарные) и вертикальными с электродами в виде цилиндров и многогранных призм.
Некоторые распространенные варианты конструкций системы ионно-плазменного травления приведены на рис. 1. Планарная диодная ВЧ система содержит два дисковых электрода: заземленный (анод) и ВЧ электрод (или мишень), на который подается напряжение от ВЧ генератора. В диодной ВЧ системе возможность ИПТ любых материалов (металлов, полупроводников, диэлектриков, органических соединений и др.) сочетается с простотой конструкции и большой площадью ВЧ электрода, на которой обеспечивается равномерная ионная бомбардировка.
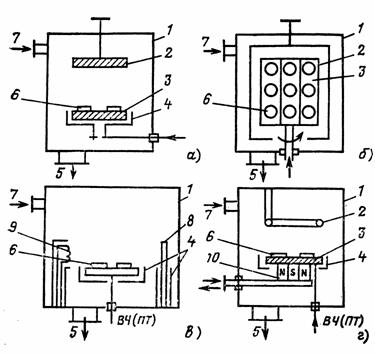
Рис.1. Системы ИПТ: а - планарная ВЧ (ПТ) диодная; б - вертикальная ВЧ (ПТ) диодная с многогранным электродом; в - триодная; г - планарная магнетронная. Обозначения: 1 - камера; 2 - заземленный электрод; 3 - ВЧ (ПТ) электрод; 4 - заземленный экран; 5 - откачка; 6 - обрабатываемые пластины; 7 - напуск газа; 8 - анод; 9 - термокатод; 10 - магнитная система.
Схема планарной диодной системы постоянного тока аналогична схеме планарной ВЧ системы (рис. 1,а), только вместо ВЧ генератора используется источник постоянного напряжения и нет необходимости в согласующем устройстве. Область применения диодных систем постоянного тока ограничена ИПТ проводящих материалов, рабочие давления лежат в диапазоне 1.33—13.3 Па, а размеры электродов и межэлектродные расстояния такие же, как у диодных ВЧ систем. Травление материалов в диодных системах постоянного тока осуществляется в аномальном тлеющем разряде при напряжении на катоде 1 - 2 кВ. В таких системах скорости ионно-плазменного травления органических масок в несколько раз ниже, чем в ВЧ системах, что позволяет проводить травление проводящих слоев на большую глубину.
Для увеличения производительности за счет загрузки большого числа пластин, а также уменьшения степени загрязнения поверхности пластин отслаивающимися от заземленного электрода пленками и частицами применяют вертикальную диодную ВЧ систему с многогранным ВЧ электродом (рис. 1,б). В такой системе для увеличения равномерности травления может быть использовано вращение ВЧ электрода.
Триодная система ИПТ состоит из трех независимо управляемых электродов: термокатода, анода и мишени, на которой размещаются обрабатываемые пластины (рис. 1,в). После откачки рабочей камеры до давления 10-4 Па катод разогревается до температуры, достаточной для достижения высокой плотности тока термоэлектронной эмиссии. Затем в камеру напускается инертный газ и между термокатодом и анодом подается напряжение около 50 В, что приводит к зажиганию дугового разряда. На мишень может подаваться как постоянное отрицательное напряжение при травлении проводящих материалов, так и ВЧ напряжение при травлении диэлектриков. В триодной системе процессы образования плазмы и травления разделены, что позволяет управлять энергией ионов с помощью напряжения на мишени. К недостаткам триодной системы следует отнести трудность получения однородной плазмы из-за малого размера термокатода по сравнению с холодным катодом диодной системы, что приводит к неравномерности травления образцов по поверхности мишени. Наличие термокатода также ограничивает ресурс работы триодной системы до его смены.
В планарной магнетронной системе ИПТ (рис. 1,г) под плоским ВЧ электродом (мишенью) размещены постоянные магниты, форма полюсов которых определяет геометрию замкнутой зоны у поверхности мишени в виде вытянутой буквы «О». Наличие у мишени замкнутого магнитного поля дает возможность локализовать плазму в непосредственной близости у мишени и повысить плотность ионного тока на мишень. Для обеспечения равномерности ионно-плазменного травления в системе предусмотрено сканирование магнитного поля по диаметру мишени с помощью перемещения магнитной системы. Наличие магнитного поля с индукцией 0.10—0.12 Тл позволяет проводить ионно-плазменное травление при давлении 1 -10 Па, обеспечивая энергию ионов 250 эВ при плотности ионного тока ~ 6 мА/см2. Таким образом, в планарной магнетронной системе при высоких скоростях травления материалов резко уменьшается возможность их радиационного повреждения вследствие низких энергий ионов.
Скорости ИПТ материалов при одинаковых условиях различаются не более чем в 2 - 3 раза, поэтому селективность ИПТ обычно не превышает 2 - 3, что в большинстве случаев недостаточно для проведения размерной обработки материалов. Топография получаемого профиля при ионно-плазменном травлении рабочего материала (подложки) через проявленную защитную маску определяется зависимостью скорости травления от угла падения ионов, переосаждением распыляемого материала и отражением ионов при больших углах падения.
По своему механизму процесс ионно-плазменного травления должен обладать высокой анизотропией, однако низкие стойкость масок и селективность травления материалов, сильная зависимость скорости травления от угла падения ионов, затрудненный выход распыленного материала из глубоких канавок при используемых рабочих давлениях ограничивают показатель анизотропии в диапазоне 5 - 10.
Равномерность ионно-плазменного травления определяется равномерностью распределения плотности ионного тока по поверхности мишени или катода. В диодных ВЧ системах и системах постоянного тока с планарными и коаксиальными электродами неравномерность травления обычно не превышает 5 - 10%, за исключением краевых участков шириной 20 -30 мм. В триодных системах неравномерность травления составляет 10 -20 % из-за изменения плотности плазмы, а следовательно, и плотности ионного тока вдоль поверхности мишени. В магнетронных системах зона травления локализована и имеет небольшую ширину, поэтому для обеспечения равномерности ионно-плазменного травления производят перемещения зоны травления относительно мишени за счет сканирования магнитной системы. При этом неравномерность травления составляет также 5 -10 %.
Процессы ИПТ всегда сопровождаются образованием радиационных дефектов, которые подразделяются на дефекты смещения, связанные со смещением атомов в решетке материала и образованием вакансий, и ионизационные дефекты, обусловленные ионизацией атомов решетки. К числу частиц, способных вызывать радиационные повреждения в обрабатываемых материалах при ионно-плазменном травлении, относятся ионы, электроны, нейтральные атомы и фотоны. Внедрение заряженных частиц в твердое тело вызывает ионизацию атомов решетки и возбуждение их электронных оболочек. В металлах с их высокой электропроводностью ионизация, вызванная облучением заряженными частицами, очень быстро (за время 10-16-10-19с) нейтрализуется электронами проводимости, и этот процесс не приводит к каким-либо заметным изменениям электрофизических свойств металлических пленок. В полупроводниках под действием бомбардировки энергетическими частицами и излучения резко возрастает электропроводность. Однако этот эффект тоже не является длительным и устойчивым, и после прекращения облучения электропроводность возвращается к начальному уровню. Только в диэлектриках наблюдаются глубокие и устойчивые изменения электрофизических и химических свойств. Например, облучение пленок SiO2 электронами с дозой около 1 Кл/см2 или ионами с дозой примерно 10 мКл/см2 приводит к увеличению скорости травления облученных участков в травителях на основе плавиковой кислоты в 3 - 4 раза.
Перечисленные выше ограничения привели к тому, что в настоящее время процессы ИПТ практически не используются для размерного травления материалов, но находят широкое применение для планаризации (сглаживания) и очистки их поверхностей. В то же время высокая эффективность очистки поверхности материала от различных загрязнений и адсорбированных газов, простота реализации и возможность интеграции в одной вакуумной камере с процессами и устройствами осаждения делают ионно-плазменное травление незаменимым для предварительной очистки подложек в одном вакуумном цикле перед нанесением функциональных слоев. Кроме этого, процессы ИПТ становятся конкурентоспособными и даже предпочтительными при травлении слоев меди и никеля в печатных платах больших размеров.